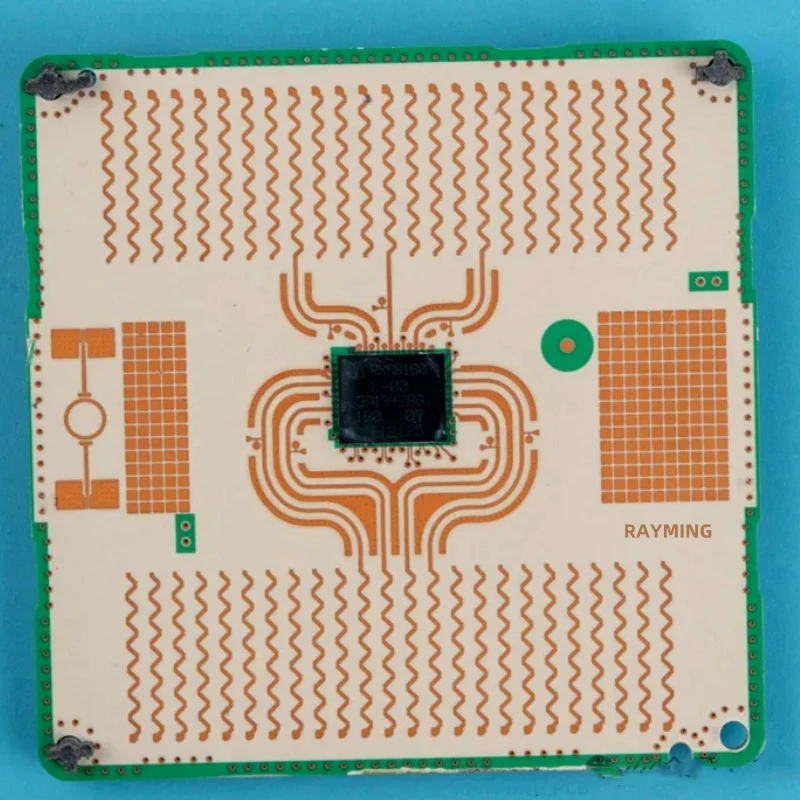
Compute
Compute accelerator
BGA 0.3 mm с boundary-scan, underfill и vacuum reflow logs.
Boundary-scanUnderfillVacuum

0.3 MM PITCH • 01005 • VOID CONTROL
DFM, stencil/paste, placement ±25 µm, nitrogen reflow, tracking AXI/void, underfill и контролируемый rework обеспечивают надежность скрытых соединений в пилотах и серийных партиях.
Мы объединяем контроль процесса и данные инспекции, чтобы «скрытые» соединения отгружались с доказательствами.
Поддерживаем via-in-pad, PoP и медью заполненные microvias.
Vision + vacuum support удерживают CpK ≥1.33.
Tuning stencil/paste/profile + vacuum dwell.
ПОКРЫТИЕ
Каждый gate — DFM, stencil, placement, reflow, inspection, underfill, rework — ведет одна команда, чтобы yield оставался стабильным, а циклы доработки были под контролем.
DFM & land pattern
Проверки pad design, mask clearance, via-in-pad fills и баланса меди снижают warpage.
Stencil & paste
Area ratio, step-stencil, паста Type 5/6 и SPI feedback стабилизируют депозиты.
Placement & reflow
Placement ±25 µm, vacuum support, nitrogen reflow ΔT ≤5 °C с thermocouples.
Inspection & rework
3D AOI, AXI sampling, void reports, underfill, staking и процедуры rework ≤3 цикла.

PLAYBOOK
Определенные gate-этапы удерживают стабильность high-density BGA/QFN сборки от intake до rework.
Package intake
Собрать drawings, pad stacks, paste specs и void targets.
Process tuning
Выбор stencil/paste, placement и reflow simulations.
Production run
SMT с 100% SPI/AOI, vacuum support и nitrogen reflow.
Inspection & analytics
AXI, void reports, ionic checks и SPC dashboards.
Underfill & rework
Выполнить underfill/staking и контролируемый rework ≤3 цикла с post-AXI.
PORTFOLIO
Сборки со скрытыми соединениями, которые мы выполняем ежеквартально, с документированным void control и лимитами rework.
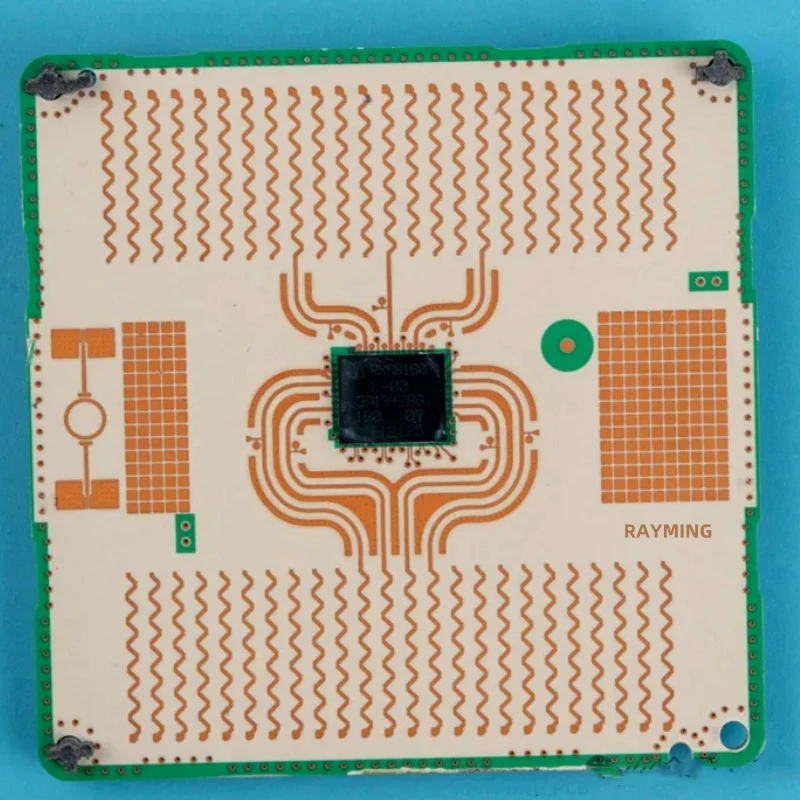



CAPABILITIES
Инструменты, оснастка и аналитика для надежной сборки со скрытыми соединениями.
Выделенные зоны reflow, AXI, underfill и rework с контролем влажности.



КАЧЕСТВО
Inline inspection, AXI и void analytics делают скрытые соединения видимыми.
Area-ratio checks, paste height SPC и feedback loops по принтеру.
AXI sampling и C-SAM/void reports с целями BTC <10%.
≤3 цикла с site dressing, печатью пасты и post-AXI verification.
High-density BGAs с boundary-scan, underfill и rework traceability.
Cleanliness, AOI/AXI и rework logs для Class II/III devices.
Void/hi-pot данные и PPAP-ready evidence для ECU и инверторов.
Shielded RF modules с контролируемым reflow и void targets.
Everything you need to know about HDI PCB technology
Загрузите файлы, чтобы получить DFM-, процессный и инспекционный план для скрытых соединений.